レノボ、「ThinkPad X300」の技術説明会を開催:恒例のThinkPad勉強会
レノボ・ジャパンは3月24日、同社製品に関するプレス向けテクノロジーブリーフィングを開催した。ThinkPad開発の拠点、大和事業所のエンジニアによる技術セミナーはこれで5回目。昨年の夏から、ThinkPadのデザインや機構設計、キーボード、“拷問部屋ツアー”、熱設計の歴史が取り上げられてきたが、今回のテーマは“究極のThinkPad”こと「ThinkPad X300」に関するものだ。大きく「回路設計」「基板設計」「EMC設計」の3点から、X300を貫く“ThinkPadの哲学”が語られた。
ThinkPad X300の回路図面は約100ページ
技術セミナーの前半部分を担当したレノボ・ジャパンノートブック開発研究所システム技術基礎設計技術の小川満氏は、「今回、薄さに特化したX300という機種を開発するにあたって、それがどれだけとんがった製品であっても、やはりThinkPadでなければいけない」とその基本コンセプトを語り、X300は回路設計の段階から“ThinkPadらしさ”を追求してきたと説明した。
例えば、ThinkPad X300の回路図面は、「通常のノートPCなら50〜60ページ、多くても70ページほど」(小川氏)の分量に対して、約100ページにもおよぶが、その理由は基本回路の部分をすべてのThinkPadと共通化しているためだという。ThinkVantage機能のフルサポートをはじめ、システム・マネージメント用マイコンや電源管理用のカスタムチップの実装など、“ThinkPadらしい”機能や安全設計を踏襲しつつ、さらにそのうえで、高密度実装や省電力機能といったX300特有の専用回路が存在するというわけだ。
小川氏は、製品間の差異を小さくするこの設計アプローチのメリットとして、「何か(回路上の)問題が発見された際にすべての製品で修正が適用できる」ことと「各製品間でユニークな部分を明確化することにより、そのユニークな部分に開発リソースを集中できる」ことの2点を挙げ、最新のX300も同様に従来のThinkPadの回路設計を受け継ぐものであることを強調した。
SFFパッケージとHDI基板が実現したX300の薄型軽量ボディ
ThinkPad X300の特徴である薄型軽量ボディは、システム基板の高密度実装を可能にした2つの技術が核になっている。1つは富士通の「LOOX R」でも使用されているインテルのSFF(Small Form Factor)パッケージを採用したCPU(Core 2 Duo SL7100)とチップセット(Intel GS965 Express)、そしてもう1つが内層基板内での配線を可能にしたHDI基板だ。
CPUのパッケージサイズは、ThinkPad T61で採用される35(幅)×35(奥行き)×2.9(厚さ)ミリの通常パッケージに比べて、SFFパッケージが22(幅)×22(奥行き)×2(厚さ)ミリと非常に小さく、同様にノースブリッジとサウスブリッジも小型化している。
一方、システム基板の表層と2層目(ブラインド・ビア)、2層目と9層目の間(ベリード・ビア)を接続するX300のHDI基板(1+8+1層)は、基板の表裏を貫通するPTH(Plated Through Hole)タイプのビアのみが使用されるThinkPad T61のFR4(10層)基板に比べて高密度の実装が可能なため、面積で約52%、重量で約60%ほど削減され、厚さも1.2ミリから1ミリとさらに薄くなった。また、部品点数も2660点から1820点と大幅に減っている。
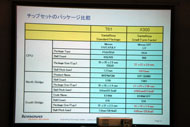
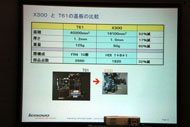
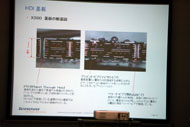 CPUとチップセットのサイズ比較(写真=左)。FR4基板(10層)とHDI基板(1+8+1層)のサイズ比較(写真=中央)。X300の基板断面図。基板の2層目と9層目を形成したあとに表と裏をさらに層で挟むHDI基板では、表層と2層目(ブラインド・ビア)、2層目から9層目(ベリード・ビア)を接続できるため、高密度実装が可能だという(写真=右)。この技術は、高密度実装を求められるモバイルノートPCの基板では他社でも使われているが、実はブラインド・ビア技術自体は、1994年発売のThinkPad 755Cですでに採用していたという
CPUとチップセットのサイズ比較(写真=左)。FR4基板(10層)とHDI基板(1+8+1層)のサイズ比較(写真=中央)。X300の基板断面図。基板の2層目と9層目を形成したあとに表と裏をさらに層で挟むHDI基板では、表層と2層目(ブラインド・ビア)、2層目から9層目(ベリード・ビア)を接続できるため、高密度実装が可能だという(写真=右)。この技術は、高密度実装を求められるモバイルノートPCの基板では他社でも使われているが、実はブラインド・ビア技術自体は、1994年発売のThinkPad 755Cですでに採用していたというただし、HDI基板の採用にあたっては、品質・信頼性を確保するためにさまざまな評価も行ったという。例えば、ブラインド・ビア上に部品のリードをはんだ付け(ビア・イン・パッド)することでさらなる高密度実装化が可能だが、現在の技術ではどうしても内部に気泡が入ってしまい、ひび割れなどによる断線によって信頼性は落ちる。そこで実際に基板の屈曲テストなどの基礎実験を行い、その評価を元に配線の引き出し方法やビア・イン・パッドの使用場所を制限するなど、品質を保つためのデザインルールを決定している。
また、基礎実験だけでなく、実際に基板を筐体に組み込んだ状態で負荷をかけ、そのひずみを測定することで、部品の配置やねじ止め位置、接着剤の使用の有無を最適化したり、測定できない信号波形や電源パターンの評価ではシミュレーションを活用しているという。

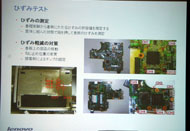
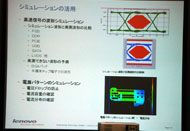 評価用のBGA実装基板を用意し、基板にさまざまな負荷をかけて破壊に至るプロセスを検証し、基板のデザインルールを決定する(写真=左)。実際に筐体に組み込んだ状態で基板のひずみを測定し、問題があれば部品やねじのレイアウトを調整する(写真=中央)。実測できないものについてはシミュレーションを活用する(写真=右)
評価用のBGA実装基板を用意し、基板にさまざまな負荷をかけて破壊に至るプロセスを検証し、基板のデザインルールを決定する(写真=左)。実際に筐体に組み込んだ状態で基板のひずみを測定し、問題があれば部品やねじのレイアウトを調整する(写真=中央)。実測できないものについてはシミュレーションを活用する(写真=右)最近の電磁波事情
このほか説明会では、同社ノートブック開発研究所システム技術基礎設計技術担当の小見山博秀氏が、最近の電磁波事情を受けた同社の取り組みを紹介した。EMC対策は、ノートPCが外部の電磁波から受ける影響と、ノートPCの発する電磁波が外部に与える影響の2つに分けられ、それぞれに対して許容値を設定した規格が存在する。しかし同社は、「ノートPCはノートPCなりの、家電では家電なりの使用環境があるはず」という立場から、それらのレギュレーションにとどまらない、レノボ独自の「Lenovo Standards」と「PAL」を設定し、これらを満たす試験も行っている。
例えば、ノートPCの上に置いた携帯電話が受信した際にシステムが誤作動する、イーサネットケーブルを接続した際に静電気でシステムがクラッシュする、などの報告があったため、そういった状況下でも影響を受けにくい構造を採用したり、部品ごとの電磁波対策を施しているという。
小見山氏は、今後もこうした基礎実験と顧客からのフィードバックをさらに積み重ね、ThinkPadであり続けるための新しい挑戦をしていきたいと抱負を語った。
関連記事
 ThinkPad X300に込められた“大和”魂
ThinkPad X300に込められた“大和”魂
IBMからレノボに変わって多くのThinkPadが登場した。「何も変わらない」とレノボはいうが「何かが違う」と思うユーザーも少なからずいた。そんなユーザーを熱くさせる新生ThinkPadが出現したのだ。 大和研が誇る「ThinkPad X300」を速攻で分解した
大和研が誇る「ThinkPad X300」を速攻で分解した
レノボが威信をかけて投入した薄型軽量モバイルノートPC「ThinkPad X300」は、中身もスゴイのか。試作機を分解し、ボディ内部を探ってみた。 薄く、軽く、そして頑丈なモバイルノート――写真で解説する「ThinkPad X300」
薄く、軽く、そして頑丈なモバイルノート――写真で解説する「ThinkPad X300」
13.3インチワイド液晶と光学ドライブを搭載し、厚さ18.6〜23.4ミリ、重量約1.42キロを実現した「ThinkPad X300」。そのボディをじっくりチェックした。 大和の技術を結集した“究極のThinkPad”――「ThinkPad X300」発表会
大和の技術を結集した“究極のThinkPad”――「ThinkPad X300」発表会
13.3インチワイドで最軽量、最薄のモバイルノート「ThinkPad X300」は、ThinkPadの哲学を守る「ThinkPadらしいThinkPad」でありながら、Xシリーズの携帯性とTシリーズの機能を両立した。 レノボ、ノートPC「ThinkPad R61」など計3モデルにPenrynコア搭載モデルを追加
レノボ、ノートPC「ThinkPad R61」など計3モデルにPenrynコア搭載モデルを追加
レノボ・ジャパンは、同社製ノートPC「ThinkPad R61」「Lenovo 3000 V200」「Lenovo 3000 N200」の3モデルに、それぞれCore 2 Duo T8100搭載モデルを新たに追加した。 ThinkPadに隠された“フクロウの羽根”の秘密
ThinkPadに隠された“フクロウの羽根”の秘密
ThinkPadの冷却システムは、アイスクリームサーバやフクロウの羽根をヒントに作られている、と聞いたらあなたは驚くだろうか。 ThinkPad15周年モデルの「ThinkPad X61s 15th Anniversary Edition」を発売――315台限定
ThinkPad15周年モデルの「ThinkPad X61s 15th Anniversary Edition」を発売――315台限定
レノボは、ノートPC「ThinkPad」15周年を記念したモデル「ThinkPad X61s 15th Anniversary Edition」を発表した。販売台数は315台限定。 ThinkPadのキーボードが打ちやすい理由――大和のエンジニアかく語りき
ThinkPadのキーボードが打ちやすい理由――大和のエンジニアかく語りき
文字が入力しやすいノートPCの代表格といえるThinkPad。そのキーボードとトラックポイントのデザインは、細部に至るまで考えた末での結論だった。 「数値ではない」ことを重視するThinkPadの機構設計
「数値ではない」ことを重視するThinkPadの機構設計
「耐荷重100キロ超」「重さ1キロ未満」とイマドキのノートPCは数値で性能を訴求する。だが、ThinkPadで大事なのは数値でない。その真意を機構設計の第一人者が語った。 “らしさ”を作るレノボのデザイン哲学
“らしさ”を作るレノボのデザイン哲学
「ThinkPad」シリーズは、IBM時代から大和事業所で開発が行われている。そこで活躍するエンジニアとデザイナーがその取り組みについて説明する、ラウンドテーブルが8月24日に行われた。 日本でも欲しいっ! 革をまとったThinkPad X61が国内で初披露
日本でも欲しいっ! 革をまとったThinkPad X61が国内で初披露
歴代のThinkPadを知るユーザーなら、筐体を革でくるりと巻いた「のり巻きケース」という言葉に反応するだろう。欧米で登場した「特別なThinkPad」はもっともっと本格的らしい。 レノボとKDDI、WIN対応通信モジュールを搭載したThinkPad X61/X61sを発表
レノボとKDDI、WIN対応通信モジュールを搭載したThinkPad X61/X61sを発表
レノボ・ジャパンとKDDIは、CDMA 1X WINに対応したPCI Express Mini Card規格の通信モジュールを内蔵したThinkPad X61とX61sを発表した。オンラインサインアップで3Gネットワークが利用できる。 レノボ・ジャパン、ThinkPad 「X61s」「T61p」「R61」「R61e」発表
レノボ・ジャパン、ThinkPad 「X61s」「T61p」「R61」「R61e」発表
レノボ・ジャパンはThinkPadの新製品「X61s」「T61p」「R61」「R61e」を発表した。2007年5月に発表された“Santa Rosa”ThinkPadの追加モデルとなる。 ThinkPadの“拷問部屋”を体験してきました
ThinkPadの“拷問部屋”を体験してきました
IBM時代からThinkPadを生み出しきた大和事業所には、設計・開発を行う研究棟以外にも、“トーチャーテスト”という何やら恐ろしげな試験のための施設や、歴代ThinkPadを飾った展示スペースがある。覗いてきました。 ThinkPad XシリーズもSanta Rosaに進化
ThinkPad XシリーズもSanta Rosaに進化
レノボ・ジャパンは5月31日に、ThinkPad XシリーズとLenovo 3000 Vシリーズの新製品を発表した。先日登場した姉妹機同様、Santa Rosa世代のCentrinoを採用する。 “Santa”なThinkPadが登場
“Santa”なThinkPadが登場
レノボ・ジャパンは5月22日に、ThinkPad TシリーズとRシリーズ、Lenovo 3000 Nシリーズの新製品を発表した。TシリーズとNシリーズは“Santa Rosa”世代のCentrinoを採用する。 ThinkPadは“黒いBento Box”である(後編)――黒くて四角いアイデンティティ
ThinkPadは“黒いBento Box”である(後編)――黒くて四角いアイデンティティ
語られるようでいて実は語られていない、PC・周辺機器のデザインにフォーカスした本連載。PCメーカー編の第5回はレノボ・ジャパンの「ThinkPad」シリーズ後編をお届けする。 ThinkPadは“黒いBento Box”である(前編)――ThinkPadのデザイン思想
ThinkPadは“黒いBento Box”である(前編)――ThinkPadのデザイン思想
語られるようでいて実は語られていない、PC・周辺機器のデザインにフォーカスした本連載。PCメーカー編の第4回はレノボ・ジャパンの「ThinkPad」シリーズだ。 “ThinkPadの父”内藤氏が語る「ThinkPad X60 Tablet」
“ThinkPadの父”内藤氏が語る「ThinkPad X60 Tablet」
電磁誘導式と感圧式の両方に対応した業界初のタブレットPC「ThinkPad X60 Tablet」について、ThinkPadの生みの親でもあるレノボ・ジャパン取締役副社長の内藤氏に話を聞いた。
関連リンク
Copyright © ITmedia, Inc. All Rights Reserved.
アクセストップ10
- もう全部、裏配線でいいんじゃない? 「ASUS BTF DESIGN」が示す自作PCの新しい形 (2024年04月19日)
- ノートPCに外付けキーボードを“載せて”使える「タイプスティックス/打ち箸」に新色 (2024年04月18日)
- さらなる高速化を実現! PCI Express 5.0接続SSDの新モデル「Crucial T705」を試して分かったこと (2024年04月18日)
- 話題になったトラックボール「IST」も登場! エレコムのPC周辺機器が最大21%お得に買える (2024年04月19日)
- Core Ultra搭載の「Let's note FV5」を徹底検証 プレミアムモバイルの実力は? (2024年04月19日)
- MSI、第12世代Core i3/i5を採用したミニデスクトップPC「Cubi 5」 (2024年04月19日)
- ついに8K対応した「Insta360 X4」の画質をX3と1インチ360度版で比較 今買うべき全天球カメラだと確信した (2024年04月16日)
- あなたのPCのWindows 10/11の「ライセンス」はどうなっている? 調べる方法をチェック! (2023年10月20日)
- バッファロー製Wi-Fiルーターに脆弱性 対象機種は今すぐファームウェア更新を (2024年04月17日)
- 東プレREALFORCEキーボードが10%オフ! ゲーミングキーボードも対象に (2024年04月18日)
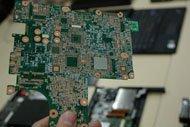

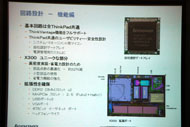
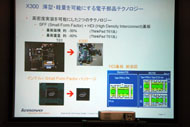
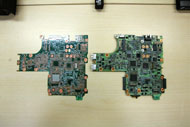
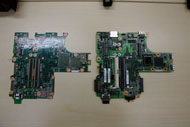

 レノボ・ジャパン ノートブック開発研究所システム技術基礎設計技術担当 小見山博秀氏
レノボ・ジャパン ノートブック開発研究所システム技術基礎設計技術担当 小見山博秀氏